发布日期:2018-10-18 17:05 来源:活性炭网 作者:活性炭网 浏览数:
内容概要 随着各种表面分析手段的发展和进步,迫切需要建立一种定量分析方法,并将其应用于各个方面。 在这种情况下的重要因素包括固体表面的二维和三维分析以及在入射光束尽
随着各种表面分析手段的发展和进步,迫切需要建立一种定量分析方法,并将其应用于各个方面。在这种情况下的重要因素包括固体表面的二维和三维分析以及在入射光束尽可能小的局部分析中的分辨率和灵敏度改进。另一方面,作为实际问题,合金材料和复合材料经常需要进行分析,但在这种情况下,除了元素分析外,还需要进行状态分析,建立定量分析方法尤为重要。那里。
对于在表面处建立定量形态分析的目的,并通过由碳化硅材料表面受到进行的研究使用了该报告的无机固体化合物中,X射线光电子能谱法(XPS下文下文)的深度方向一。
碳化硅(以下简称为SiC)具有各种工程应用,但最近有望作为聚变反应堆的第一壁材料,并且从与等离子体的相互作用的观点来看,研究实例正在增加。特别是,为了减少杂质污染到等离子体中,在金属表面上涂覆低原子序数材料引起了人们的注意。在本研究中,我们首先选择了均匀蚀刻的最佳条件,并在XPS状态分析中检测了光电子产率,并建立了深度方向的定量状态分析方法。接下来,我们试图通过将该方法应用于作为聚变反应堆的第一壁材料的SiC膜来证明该方法的适用性。结果,虽然留下了一些未解决的问题,但是有可能建立一种能够承受大量实际应用的方法。
在未来,有必要改进更高的量化精度和深度方向分辨率,但是已经证明XPS可以是用于分析深度方向上的薄膜的非常强大的测量工具。通过与其他方法(例如俄歇分析)相结合的同时测量将是更有效的分析手段。
1。实验方法
(1)XPS设备
本研究中使用的设备是AEIES-200型X射线光电子能谱仪,其样品室配置如图1所示。用于溅射蚀刻的离子生铁是由PHI Co.,Ltd。制造的5KeV。在标准使用条件下可以对最大10mm×10mm的试样表面进行光栅环。由于样品可以旋转,因此可以在设定每个预定位置的情况下交替重复XPS测量和溅射蚀刻。通过扩散泵将样品室的内部保持在3×10 -1托或更低。Alkα(hv = 1486.6eV)用作激发X射线。Au 4 f 7/2的结合能标准设定为83.8eV。根据需要,进行从非常薄的金沉积Au4f7 / 2在这种情况下,样品表面的基线使用移位量校正进行由于样品的充电的峰值位置的偏移的校正。
使用氩离子进行溅射蚀刻,并且相对于样品表面的离子入射角为30°,并且对具有5kV(直径约1mm)的电压的光束进行光栅扫描。离子电流为10μA/ cm 2,氩气的纯度为99.998%。
(2)样品
在该研究中,除了高纯度硅单晶晶片之外,还使用SiC涂层膜作为样品。涂覆的样品表示为A / B,表明在基底B上形成的膜是A. 通过CVD法在热解碳基板上涂布40μm的SiC,得到SiC / C,通过X射线衍射确认为β-SiC。SiC / Mo是通过高频溅射沉积在钼基板上的3μmSiC。
2。结果和讨论
(1)屏蔽对XPS的影响
使用市售的离子枪进行溅射蚀刻难以均匀地蚀刻大面积,并且需要预先研究离子密度的均匀性。因此,我们设计了一种使用盾牌并选择其状态的方法。
(2)通过XPS量化状态分析
由于可以从XPS测量分析固体表面的状态,如果建立测量结果的定量分析方法,将提供非常有用的信息。在这项研究中,我们研究了一种方法,用于分离硅样品的XPS光谱中不同状态的峰,并在分数中定量显示。
(3)XPS在SiC涂膜上的应用
首先,使用SiC / C进行XPS测量,其中通过X射线衍射证实本体结构为β-SiC。
图2示出了光谱如何随溅射蚀刻而变化。最初,C IS光谱给出了复杂的形状,但在60分钟的蚀刻后,它是单峰。此时,根据俄歇分析的结果,表面组成被认为是Si:C = 1:1。由此,将蚀刻60分钟后的表面作为SiC标准,并且将从测量获得的峰形和参考数据用于随后的分析。图3显示了由SiC(C IS(SiC),Si 2p(SiC))和剩余峰(C)引起的C IS和Si 2p峰IS(残油),Si 2p(氧化))并且显示使用C IS,0 IS和Si 2p的相对灵敏度获得的组分分数的变化。使用已知厚度的SiC膜,以4.4埃/分钟的蚀刻速率对水平轴上的深度标尺进行缩放。从图中可以看出,表面被轻微氧化,并且即使C(渣油)降低至约200埃的深度,也存在C(渣油)。C IS(渣油)的峰位置是烃的位置,其似乎首先是由于表面污染,但是在蚀刻1分钟后它移动到石墨的位置。据此,估计过量的碳作为游离碳存在于该膜的表面上。
接下来,在参考SiC / C的结果的同时进行SiC / Mo的XPS测量。由于该样品的SiC膜的厚度薄至约3μm并且结晶度不好,因此不可能通过X射线衍射进行识别。以与SiC / C的情况相同的方式检查通过溅射改变的组成,结果示于图3中。每种成分的变化模式与SiC / C非常相似。但与SiC / C相比,从光泽度的差异推断,因为在SiC / Mo的表面具有更大的粗糙度,因为显然大的厚度由碳过量层沿着大的表面不规则性存在有可能观察到,并且只有该实验结果才能进行精确的厚度比较。我们正在继续研究富碳层的详细结构及其原因。
特点
碳化硅具有各种工程应用,但最近认为它是第一种熔融壁材料。本研究旨在通过X射线光电子能谱建立碳化硅表面和深度方向的定量状态分析方法。结果,该方法被证明是用于分析深度方向上的薄膜的非常强大的技术。
核电站炉壁材料表面评价技术,通用电厂汽轮机关系,其他材料

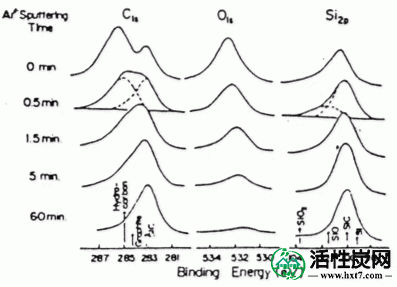
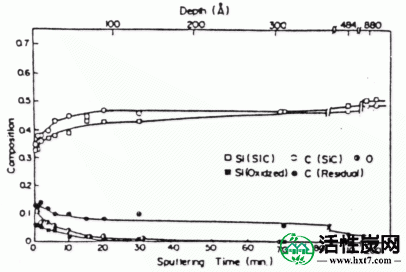
 (责任编辑:活性炭网)
(责任编辑:活性炭网)